技术指导:BGA设计规则
创建时间:2019-10-26 15:57 更新时间:2026-01-30 17:06  173281
173281
 46
46
 文档错误过时,
我要反馈
文档错误过时,
我要反馈
 173281
173281
随着电子产业技术的进步,芯片集成度不断提高,IO引脚数急剧增加,功耗也随之增大,对集成电路封装的要求也更加严格。
为了满足发展的需要,BGA (Ball Grid Array)-球状引脚栅格阵列封装技术被应用于生产,它是在封装体基板的底部制作陈列
焊球作为电路的I/O端与印刷线路板(PCB)互连,采用该技术封装的器件是一种表面贴装器件。

随着芯片产业的发展,BGA间距越来越小,布线越来越密,以满足更多功能,此时给生产带来了不少挑战:
1)BGA焊盘到线路距离近,且BGA焊盘需要开窗,那么就需要有一定的安全间距,传统生产中达不到此间距的只能削掉BGA焊盘
2)为了从BGA焊点内部引线出来,常规的做法是在BGA焊盘间做过孔引线,若BGA间距近就没有再加过孔,只能把过孔钻在BGA焊盘上
……
这些都给后期的SMT组装带来难度与风险,为此,我们更新设备与提升工艺,已解决了这两大难题:
■ 常规BGA过孔塞油墨生产工艺
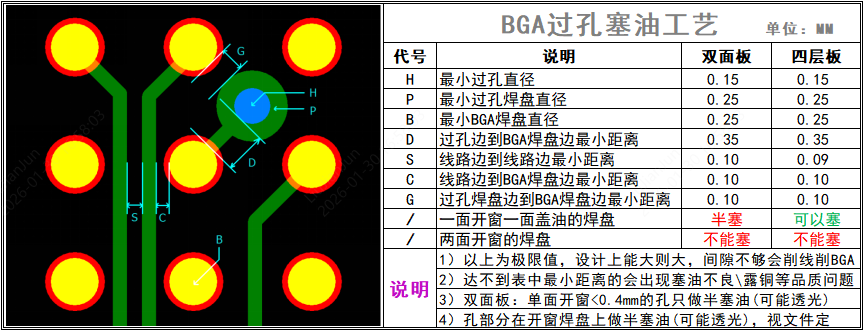
■ 高端BGA过孔盘中孔塞树脂/铜浆生产工艺
塞树脂/铜浆的应用,使盘中孔成为精密板布线的最佳选择。同时多层板更新了高端设备,可以制作更精密的BGA焊盘
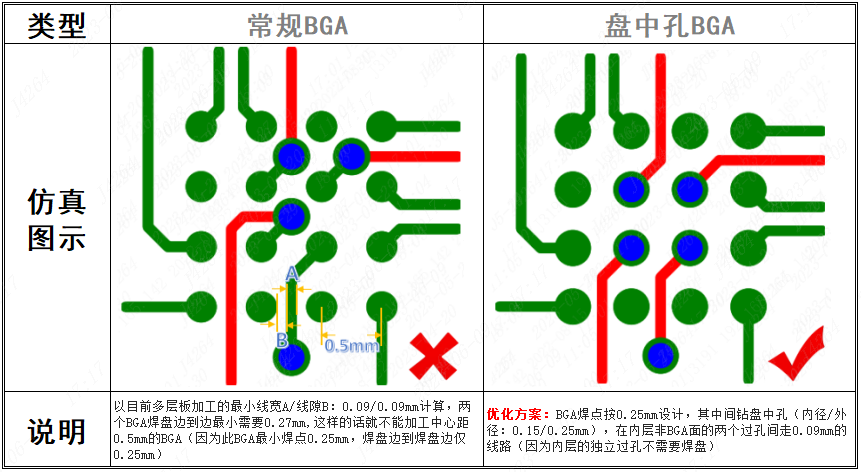
提示:
1)盘中孔中间不能塞油墨,可以塞树脂或铜浆(铜浆相对树脂导热导电性能高),再镀平BGA盘中孔焊盘
2)采用上述盘中孔塞孔工艺的,尽量把过孔(内径)做到0.2mm及以上,焊盘(外径)设计在0.35mm及以上。
3)多层板少部分线宽可以做到极限0.076mm(即3mil),能够做宽的尽量按0.09mm(即3.5mil)制作
您好,这种如果BGA中间只走一根线的话,可以用普通的方案:BGA边上加一个过孔,也可以BGA焊盘引0.1mm的线从两个BGA中间出来。
您好,盘中孔可以做0.15mm或0.2mm,外径做0.25或0.3mm,具体见此网页最底下的案例,谢谢!
您好,0.5mm的间隙太近了,建议采用盘中孔工艺(0.15mm的孔,对应0.25mm的焊盘),BGA焊盘也按0.25mm来,谢谢!
是的,常规的盘中孔最小可以做0.15mm,另外1.0mm板厚及以下支持0.1mm的微孔,谢谢!
您好,BGA焊盘0.4mm的话,盘中孔的内径可以设计为0.15-0.3mm(对应的外径比内径大0.1mm以上,但是不要超过0.4mm),BGA焊盘有阻焊层了,盘中孔就不需要再设计阻焊层了。
您好,只能部分焊盘做盘中孔,具体可以参考2025-06-25 09:51:31此帖的留言回复,谢谢!
您好,请问BGA中心距多少?您询问的最小间距是哪个跟哪个之间的距离?
您好,阻焊层设为跟BGA焊盘一样大就可以了,谢谢!~
您好,目前加工的最小盲孔是0.075mm,盲孔最小焊环0.075mm,也就是说盲孔焊盘最小需要0.075+0.075*2=0.225mm,因此0.21mm的请加大到0.225mm,谢谢!~
BGA最小做0.2mm,需要沉金工艺,且中间做0.1mm的微盘中孔(板厚不超过1mm)
- 1
- 2
- 3
- 4
- 5
- PCB帮助文档
- SMT帮助文档
- 钢网帮助文档
- PCB讨论
- SMT讨论
- 钢网讨论






















